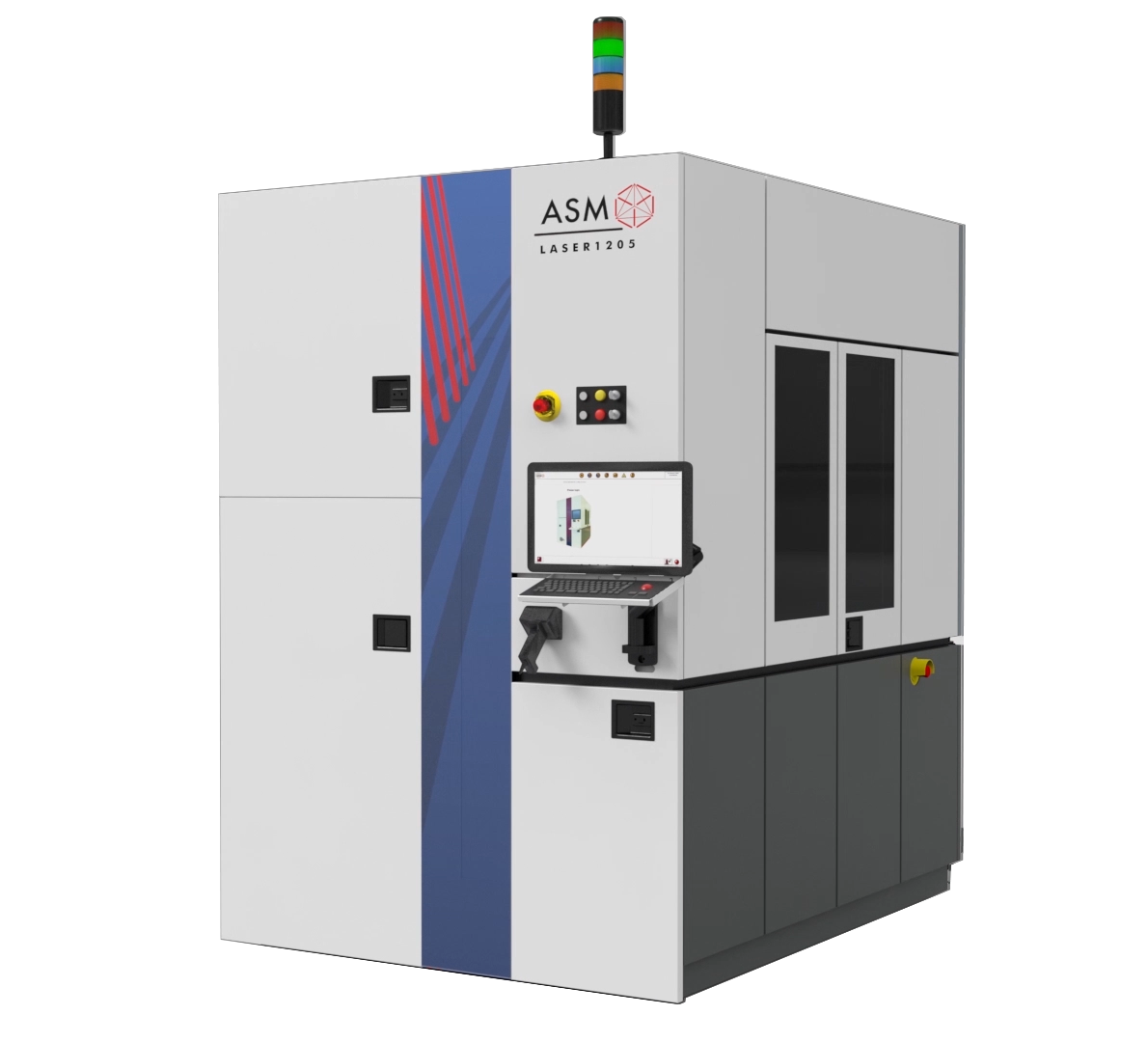 ASMPT’s laser-based wafer separation machines are leading in Edge quality with lowest Cost of Ownership based on VI dicing and/or Matrix grooving processes. ASMPT has developed a broad portfolio of options for all models to address the specific challenges of our customer’s markets, both for OSAT and tier1 IDM companies. The introduction of next gen Ultra Short Pulse (USP) systems is scheduled for first quarter 2021.
ASMPT’s laser-based wafer separation machines are leading in Edge quality with lowest Cost of Ownership based on VI dicing and/or Matrix grooving processes. ASMPT has developed a broad portfolio of options for all models to address the specific challenges of our customer’s markets, both for OSAT and tier1 IDM companies. The introduction of next gen Ultra Short Pulse (USP) systems is scheduled for first quarter 2021.
The platform
 The Laser1205 platform is a family of systems specially developed for the separation and/or grooving of semiconductor wafers by means of laser energy. The family contains fully automated systems designed for sustained high quality production in an industrial environment.
The Laser1205 platform is a family of systems specially developed for the separation and/or grooving of semiconductor wafers by means of laser energy. The family contains fully automated systems designed for sustained high quality production in an industrial environment.
The ergonomic design, the user-friendly touch screen display and the ease-of-use allow the operator to control the system easily for a wide variety of products. As the Laser1205 systems meet the industrial standards in accordance with CE regulations, no special precautions nor training are required to safely operate the systems.
| Grooving UV-USP |
Grooving UV |
Dicing UV+ |
Dicing IR |
|
|---|---|---|---|---|
| Process | Grooving | Grooving | Dicing & Grooving | Dicing |
| Kerf check on the fly | Yes | Yes | Yes | no |
| Wavelength | 343nm | 355nm | 355nm | 1064nm |
| Pulse length | ps/fs | ns | ns | ns |
| Wafer thickness | 60 – 800µm | 60 – 800µm | 20 – 200µm | 50 – 300µm |
| Wafer size | Up to 12” | Up to 12” | Up to 12” | Up to 12” |
| more | more | more | more |
